2020-03-17
2020-03-09
pam-xiamenはフォトレジストでフォトレジスト板を提供
フォトリソグラフィー除去(ストリップ)、最終検査など、ナノリソグラフィー(フォトリソグラフィー)を提供することができます:フォトリソグラフィー、フォトレジスト塗布、ソフトベーク、アライメント、露光、現像、ハードベーク。
moq :
1
ナノ加工
パム・シャーマンのオファー フォトレジスト プレート付き フォトレジスト
我々は提供することができます ナノリソグラフィー ( フォトリソグラフィー ):表面処理、 フォトレジスト 塗布、ソフトベーク、アライメント、露光、現像、ハードベーク、現像検査、エッチング、 フォトレジスト 除去(ストリップ)、最終検査。
a フォトレジスト は、いくつかのプロセスで使用される感光性材料であり、 フォトリソグラフィー および写真製版を使用して、表面上にパターン化されたコーティングを形成することは、電子産業全体において非常に重要である。
ポジレジストは一種の フォトレジスト ここで、 フォトレジスト 光に曝されているものは、 フォトレジスト 開発者。未露光部は フォトレジスト は、 フォトレジスト 開発者。
負の フォトレジスト 一種の フォトレジスト ここで、 フォトレジスト 光に曝されると、 フォトレジスト 開発者。未露光部は フォトレジスト によって溶解される。 フォトレジスト 開発者。
の化学構造に基づいて フォトレジスト 光重合性、光分解性、光架橋性、光架橋性、 フォトレジスト 。
アプリケーション:
マイクロコンタクトプリンティング
プリント回路基板(pcb)の製造
基板のパターニングおよびエッチング
マイクロエレクトロニクス
フォトレジスト 微量滴定
フューチュレックス
その他 フォトレジスト 、
詳細はお問い合わせください
基板シリコン基板2 "3" 4 "5" 6 "8"
石英基板 ssp / dsp
ガラス基板 n / p
sio2基板 100/110/111
他の基板、
詳細はお問い合わせください
ポジレジストとネガレジストの違い
|
特性 |
ポジティブ |
負 |
|
〜に対する接着力 シリコン |
フェア |
優れた |
|
相対コスト |
もっと高い |
より安価な |
|
開発者ベース |
水性 |
オーガニック |
|
の溶解度 開発者 |
露出領域 可溶性である |
露出領域 不溶性である |
|
最小機能 |
0.5μm |
2μm |
|
ステップカバレッジ |
より良い |
低い |
|
湿式化学薬品 抵抗 |
フェア |
優れた |
基本的な手順
1回の繰り返し フォトリソグラフィー いくつかのステップを順番に組み合わせています。現代のクリーンルームは、プロセスを調整するために自動化されたロボットウェーハトラックシステムを使用しています。ここで説明する手順では、間引き処理やエッジビード除去などの高度な処理は省略されています。
クリーニング
ウェハ表面に有機または無機の汚染物が存在する場合、それらは通常、湿式化学処理、例えば湿式化学処理によって除去される。過酸化水素を含む溶液に基づくrca洗浄手順。トリクロロエチレン、アセトンまたはメタノールで作られた他の溶液も洗浄に使用することができる。
準備
ウェーハは、ウェーハ表面上に存在する可能性のある水分を除去するのに十分な温度に最初に加熱され、150℃で10分で十分である。保管中のウエハは汚染を除去するために化学的に洗浄されなければならない。ビス(トリメチルシリル)アミン(「ヘキサメチルジシラザン」、hmds)のような液体または気体の「接着促進剤」を適用して、 フォトレジスト ウェーハに転写する。ウェーハ上の二酸化ケイ素の表面層は、hmdsと反応して、トリメチル化二酸化ケイ素(自動車の塗料上のワックスの層とは違わない高度の撥水層)を形成する。この撥水層は、水性現像剤が フォトレジスト 層とウエハの表面との間の接触を防止し、いわゆる フォトレジスト (現像)パターンの構造。画像の現像を確実にするために、それは120℃で温度を安定させながら、ホットプレート上に覆い、置いて乾燥させるのが最良である。
フォトレジスト 応用
ウェハは、 フォトレジスト スピンコーティングによって除去する。ウエハ上に粘性のある液体のフォトレジスト溶液が供給され、ウェハが急速に回転して均一な厚さの層を生成する。スピンコーティングは、典型的には、1200〜4800rpmで30〜60秒間実行され、0.5〜2.5マイクロメートルの厚さの層を生成する。スピンコーティングプロセスは、均一な薄層をもたらし、通常、5~10ナノメートル以内の均一性を有する。この均一性は、詳細な流体力学的モデリングによって説明することができ、これはレジストが、粘性力がレジストをウェハ表面に結合する底部よりも層の上部ではるかに速く移動することを示す。したがって、レジストの最上層は、ウェハの縁部から迅速に排出され、一方、下層は、ウェハに沿って依然として放射状にゆっくりとクリープする。このようにして、レジストの「バンプ」または「リッジ」が除去され、非常に平坦な層が残る。最終的な厚さは、レジストからの液体溶媒の蒸発によっても決定される。高アスペクト比での崩壊効果を克服するためには、非常に小さく緻密なフィーチャ(u003c125nm)に対して、より低いレジスト厚さ(u003c0.5μm)が必要である。典型的なアスペクト比は、 4:1。
フォトレジストが塗布されたウエハをプリベークして過剰 フォトレジスト 典型的にはホットプレート上で90〜100℃で30〜60秒間加熱する。
暴露と開発
プリベーキング後、 フォトレジスト 強い光のパターンに曝される。光に暴露すると化学変化が起こり、 フォトレジスト 写真現像剤との類推によって「現像液」と呼ばれる特殊な溶液によって除去される。ポジティブ フォトレジスト 最も一般的なタイプであり、露光されると現像液に可溶化する。否定的な フォトレジスト 未露光領域は現像液に可溶である。
典型的には、入射光の破壊的で建設的な干渉パターンによって引き起こされる定在波現象を低減するのを助けるために、現像前に露光後ベーク(peb)が行われる。深紫外線リソグラフィでは、化学増幅レジスト(カー)化学が用いられる。このプロセスは、「露出」反応(酸を生成し、ポリマーを塩基性現像液に可溶化する)の大部分が実際にペブ中で起こるので、時間、温度、および遅延にはるかに敏感である。
現像化学は、スピナー上で行われます。 フォトレジスト。 開発者はしばしば水酸化ナトリウム(naoh)を含んでいた。しかし、ナトリウムは、ゲート酸化物の絶縁特性を低下させるため、MOSFETの製造において極めて望ましくない汚染物質と考えられている(具体的には、ナトリウムイオンがゲートの内外に移動し、トランジスタの閾値電圧を変化させ、トランジスタは時間の経過とともにオン)。テトラメチルアンモニウムヒドロキシド(tmah)などの金属イオンを含まない現像剤が現在使用されている。
非化学的に増幅されたレジストが使用された場合、典型的には120〜180℃で20〜30分間、得られたウェハを「ハード・ベイク」する。ハードベークは残りの部分を凝固させる フォトレジスト 将来のイオン注入、湿式化学エッチング、またはプラズマエッチングにおいて、より耐久性のある保護層を作製することができる。
エッチング
エッチングにおいて、液体(「湿式」)またはプラズマ(「乾式」)化学薬品は、保護されていない領域内の基板の最上層を除去する フォトレジスト 。半導体製造においては、ドライエッチング技術が一般に使用される。なぜなら、異方性とすることができるので、 フォトレジスト パターン。これは、定義されるフィーチャの幅がエッチングされる材料の厚さと同じかそれよりも薄い場合(すなわちアスペクト比が1に近づく場合)に不可欠である。ウェットエッチングプロセスは、一般に等方性であり、浮遊構造が下層から「放出」されなければならない微小電気機械システムにとってはしばしば不可欠である。
低欠陥性の異方性ドライエッチプロセスの開発により、フォトレジストで画定されたフォトレジストを基板材料に転写することが可能になった。
フォトレジスト 除去
後 フォトレジスト それが基板から除去されなければならない。これは、通常、基板にもはや付着しないようにレジストを化学的に変える液体「レジスト剥離剤」を必要とする。あるいは、 フォトレジスト それを酸化する酸素を含むプラズマによって除去することができる。このプロセスはアッシングと呼ばれ、ドライエッチングに似ています。 1-メチル-2-ピロリドン(nmp)溶媒の使用 フォトレジスト イメージを削除するために使用される別の方法です。レジストが溶解したときに、溶剤は、80℃に加熱することによって、残渣を残すことなく除去することができる。
microposit s1800 g2シリーズ フォトレジスト
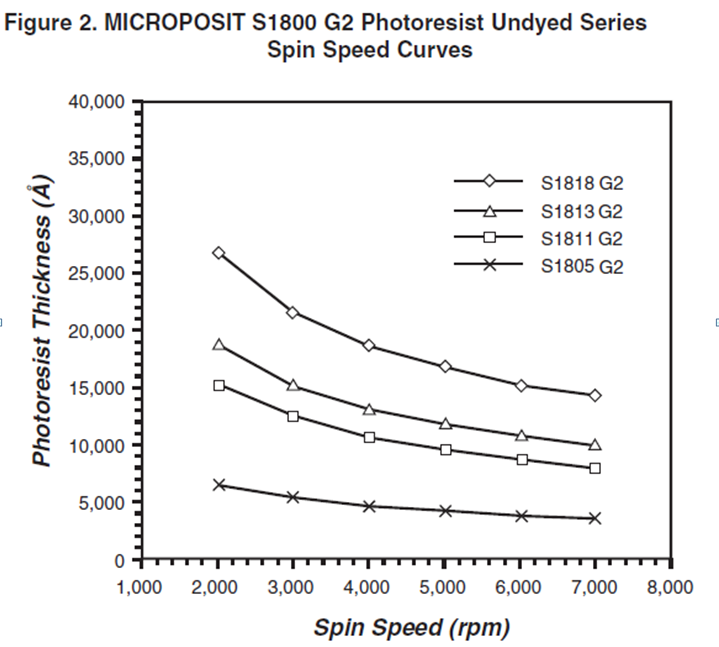
ネガレジストnr9-6000py

ネガレジストnr9-6000p
